近日,上海第二工业大学与清华大学联合研究团队在宽禁带半导体器件可靠性研究方向取得重要进展,成果发表于微电子器件领域重要国际学术期刊《IEEE Transactions onElectron Devices》。该团队通过自主研发的光电联合测量系统,深入研究了高温高频关态应力下AlGaN/GaN高电子迁移率晶体管(HEMT)中陷阱态的演化行为与空间分布,为高性能氮化镓功率器件的优化设计提供了关键实验依据。
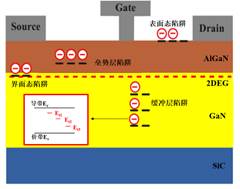
图1.HEMT内典型陷阱态分布
GaN基HEMT器件因其高电子迁移率、高饱和速度和优异的耐压性能,已成为新一代高频高功率应用的核心器件。然而,随着主频升高,HEMT常表现出发热量增加、电流崩塌加重、阈值电压漂移和安全操作边界左移的趋势,出现大幅度性能退化和寿命缩减现象。电子陷阱(陷阱态)的增生是造成上述现象的主要原因之一。因材料生长和异质界面构建,陷阱态广泛分布于HEMT器件内部(见图1),并随着器件工作时间的延长表现出显著的演化与增升特性。陷阱态拥有捕获、释放电子的能力,是干扰载流子输运的核心因素,造成局域电、热应力的集中。已有研究证明,陷阱态产生的应力在高频交变作用下引发了从界面向表面延展的微裂纹,是造成器件突发击穿的起源,制约着器件的可靠性与寿命。
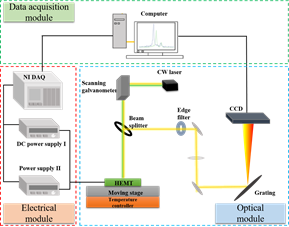
图2.光电联合陷阱态空间分辨检测平台
本研究创新性地结合瞬态电流分析技术与拉曼光谱测量方法,实现了对器件内部陷阱时间、空间的多维定位观测(见图2)。实验发现,在高温(363 K)和高频(1 MHz)关态应力作用下,器件中初始存在的四种不同类型的陷阱态表现出不同的响应,其中时间常数为微秒量级的界面陷阱态显著增升,而表面陷阱态表现出异常不稳定现象。通过变温、变电压实验和阿伦尼乌斯拟合分析,团队进一步确定了各陷阱态的能级和空间分布,并观测到近栅极界面深能级陷阱态的强度与时间常数不随温度发生改变,表现出向微裂纹演化的趋势。此外,研究还首次观察到表面态陷阱在无应力条件下的“预填充”现象,表现为等效能级0.716 eV的陷阱态效应,导致器件导通电流的持续下降,并影响其动态响应特性。

(a)

(b)

(c)

(d)
图3.高温应力后陷阱态检测:(a)界面态增生与表面态不稳定现象;(b)沟道内拉曼横向扫描;(c)贝叶斯反卷解析变温瞬态电流曲线;(d)阿伦尼乌斯拟合表面等效陷阱能级
该研究不仅深化了对GaN HEMT器件退化机制的理解,也为今后器件结构设计、工艺优化和可靠性提升提供了技术和数据支持。本工作第一作者为能源与材料学院集成电路方向李凤仪副教授,通讯作者为清华大学张兴教授和上海第二工业大学谢华清教授,相关成果得到国家自然科学基金等项目的资助。
论文信息:
FengyiLi et al., "Effect of the High-Temperature and High-Frequency Off-StateStresses on the Evolution of Traps in AlGaN/GaN HEMTs", IEEE TRANSACTIONSON ELECTRON DEVICES, 2025, doi: 10.1109/TED.2025.3603135.




